[이 글은 경제·산업·기업 등을 공부하면서 알게 된 여러 내용을 제 나름대로 요약·정리하며 쓴 글입니다.
맨 아래에 자료 출처를 표기해 두었으니 더 자세히 알고자 하시는 분은 아래 자료출처를 참고하여 찾아보시기를 바랍니다.
문제가 있는 부분을 알려주시면 수정 혹은 삭제조치 하겠습니다. ]

[간단요약]
1. 외관검사장비제조를 전문으로 하는 기업이다.
2. 연관 산업으로 반도체, HBM, 2차전지, 디스플레이, 스마트팩토리 등이 있다.
3. 영위하고 있는 사업이 성장성이 있는 사업들이다.
4. 최근 주가가 상승한 후 조정을 보이고 있다.
5. PBR 밸류에이션 상으로는 고평가 영역이다.
6. 매출 및 이익 성장이 내년부터 있을 것으로 전망된다.
[기업정보]
*외관검사장비 제조를 전문으로 하는 기업.
-머신비전기술을 통해 표면 형상에 대한 영상 데이터를 획득, 분석 및 처리하는 3D/2D 자동외관검사장비 및 모듈을 개발해 판매함.
-머신비전기술은 컴퓨터를 사용해 이미지나 비디오로부터 정보를 추출하고 분석하는 기술.
*반도체 외관검사분야, 반도체 Mid-End분야, 디스플레이 분야, 2차전지 외관검사 장비 등의 사업을 하고 있음.
*주요 매출 비중은 반도체 외관검사분야 45.8%, 반도체 Mid-End분야 31.9%로 반도체만 약 77.7%로 비중이 가장 높음.
*그 다음으로 2차전지가 12.6%, 디스플레이가 9.5% 등으로 나타남.

[주요사업 및 생산제품]
1. 반도체 후공정 외관검사분야
*반도체를 생산하는 일련의 공정에서 필요한 측정, 검사 장비와 관련된 분야.
*반도체 칩의 패키징이 완료된 후 출하 전 최종 단계에서 외관을 검사하는 반도체 패키지 검사장비(iPIS-Series), 메모리 모듈의 외관검사를 수행하는 메모리 모듈 검사장비(iMAS-Series) 및 SSD 메모리 외관 검사장비(iSSD-Series) 등을 공급.
*반도체 생산 공정에서 소자들이 형성되는 전공정이 끝난 후 진행하는 단계에서 필요한 측정, 불량 판정 시 필요한 검사.
*주요 고객사로 국내 대형 IDM 업체, 대형 OSAT 업체, 해외 미국 글로벌 IDM, 대만, 중국, 동남아 등의 OSAT 업체들이 있음.
(1)iPIS-시리즈
*반도체 패키징 완료 후 출하 직전 최종 단계에서 외관을 검사하는 반도체용 패키지 검사 장비.
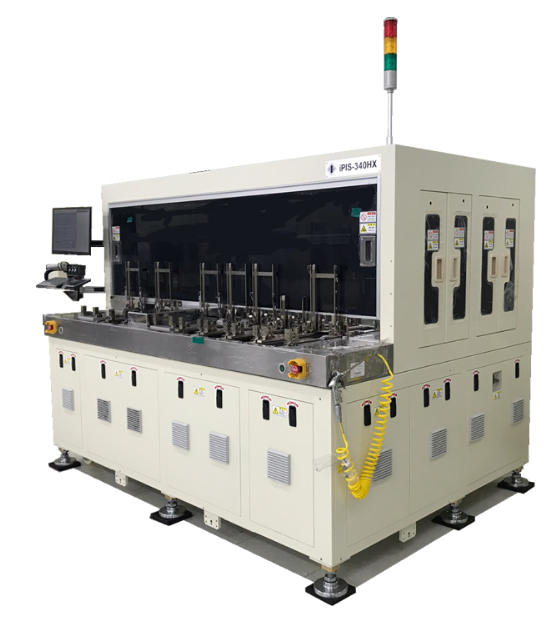
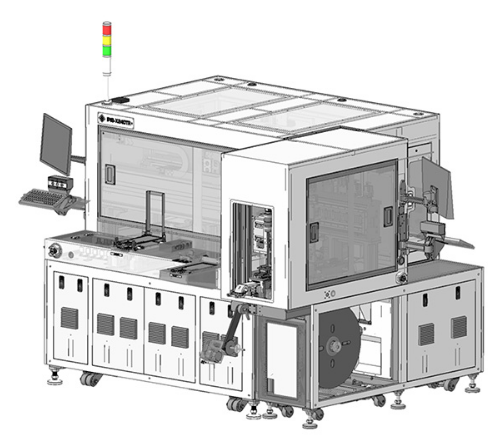
(2)iMAS-시리즈
*메모리 모듈의 외관 검사를 수행하는 메모리 모듈 검사 장비.

(3)iSSD-시리즈
*SSD 저장장치 외관 검사 장비.

2. Mid-end 외관검사장비분야
*WSI(White light scanning interferometry) 3차원 측정 기술을 바탕으로 Flip-chip에 적용되는 반도체 패키지용 Substrate의 외관을 검사하는 장비.
-최근 HPC(High Performance Computing), 5G용 PKG, AI 기술적용의 확대와 같은 반도체 분야의 기술 이슈로 Flip-Chip의 형태가 고도화되면서 Advanced 반도체 패키지에 대한 수요가 증가하면서 이 장비에 대한 수요가 함께 증가하는 중.
-WSI: 백색광주사 간섭계를 의미하며 백색광을 사용해 시료의 표면 높이나 표면의 미세힌 구조를 정밀하게 측정하는 광학 기법.
-플립칩: 반도체 칩을 뒤집어서 연결 패드가 하위 기판에 직접 접촉.
-HPC: High Performance Computing. 고성능 연산 처리를 위한 CPU, GPU, FPGA, 딥러닝 가속
*미드엔드 분야는 반도체 후공정 패키징 전후에서 전공정 수준만큼 정교하고 치밀한 공정을 필요로 하는 분야.
-범핑공정, RDL 형성 공정 등을 의미함.
*Substrate에 대한 검사 외에도 Wafer의 Bump에 대한 검사, WLP, PLP 공정 등의 미세 RDL 공정의 외관검사에도 적용될 수 있음.
-Substrate: 패키지 기판.
-WLP: Wafer Level Packaging.
-PLP: Panel Level Packaging.
-RDL: Redisribution Layer.
(1)iSIS-NBGA

(2)iSIS-FP3D

3. 디스플레이분야
*2017년부터 6세대 Flexible OLED 셀의 최종공정에서 외관을 검사하는 장비를 최초로 개발해 비전 모듈 및 소프트웨어 형태로 OLED 공정 수율을 향상시키는 솔루션 공급.
*디스플레이 업체들의 신규 라인 증설 시 신규 투자가 주기적을 발생하고 수율 개선을 위한 보완투자가 발생하는 분야.
*높은 수율을 달성하기 위해 검사 공정에 자동화 장비 도입은 필수적.
*Flexible OLED 최종 검사 장비는 인텍플러스가 독점적으로 공급했고, 완전한 형태의 장비가 아닌 비전 모듈 및 소프트웨어 형태의 솔루션 분야에서 국내 및 해외 경쟁사들이 존재함.
(1)OLED 셀 자동화 검사장비
*OLED Rigid/Flexible 셀 외관 검사기로 셀 전/후면에 발생하는 수십㎲ 불량을 검출하는 외관검사장비.

(2)OLED 셀 Review & 검사 모듈
*OLED Rigid/Flexible 셀 외관 검사 후 Review 또는 특정 영역에 대한 검사 모듈.

4. 2차전지 분야
*2차전지 분야의 외관솔루션 공급이 주된 사업분야.
*안정적인 제품 수율 확보 및 차량용 중대형 전지의 안정성이 중요해지면서 외관 검사의 필요성이 증가함.
*국내 대형 2차전지 셀 제조업체들에 셀 외관검사장비와 셀 제조 과정에서의 비전솔루션을 공급함.
(1)IBMI-E200
*배터리 셀 계측검사
*배터리 셀의 품질과 안정성 확보를 위한 계측 검사 솔루션

(2)iBMI-M100
*Compact한 광학모듈로 설비 내 공간에 설치가 가능해 다양한 공정에 검사 솔루션 도입이 가능함.

5. 스마트팩토리 분야
*자동차, 가전, 부품 가공업, 물류업 등 산업전반의 공장자동화에 필요한 '비전 모듈 및 솔루션'을 제공하는 사업.
*공장자동화는 다품종 소량생산, 빈번한 공정개선, 공정공간의 소형화, 모듈화의 흐름으로 변하는 중.
(1)i3D-800
*인텍플러스의 원천 기술인 3D 측정 기술, 2D 검사 기술, 실시간 영상 획득 및 처리 기술, 핸들러 설계 및 제작기술을 적용해 개발된 것.
*로봇시스템과 결합해 조립 공정, 가공 공정, 물류산업 등에 '빈피킹, 팔레타이징, 로봇 가이던스'와 같은 스마트팩토리 솔루션을 제공할 수 있는 3D 센서.
-빈피킹(bin-picking): 크기와 모양이 다양한 물건들 사이에서 원하는 물건을 집어내는 기술.
-팔레타이징(palletizing): 상품이나 제품을 팔레트 위에 일정한 규칙에 따라 적재하는 과정.
-로봇 가이던스: 로봇의 정밀한 위치와 움직임을 안내하는 기술.

(2)iSAF-200
*Auto-Focus Module
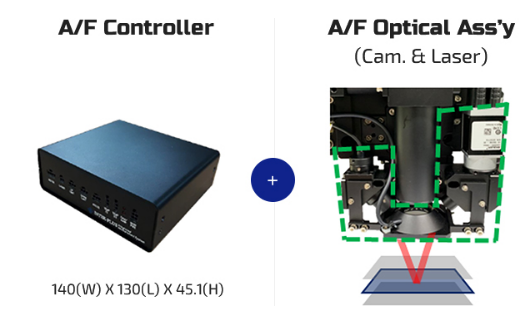
(3)Frame Grabber/Digitizer
*프레임 그래버: 머신비전 카메라의 고속/고해상도의 영상데이터를 PC메모리에 실시간으로 전송할 수 있는 PCIexpress 보드.
*디지타이저: 아날로그 신호를 기가 샘플링 하여 디지털 신호로 변환해서 PC메모리에 실시간으로 전송할 수 있는 PCIexpress 보드.

[출처]
1. 인텍플러스 한국IR협의회 보고서(2023.09.19)
2. 인텍플러스 반기보고서(2023.08.14)
3. 인텍플러스 홈페이지
인텍플러스 Intekplus
반도체, Display, 2차전지, Smart Factory, 3D/2D 측정 외관검사장비 전문기업, 회사소개, 제품정보, 채용정보 제공
intekplus.com
[참고자료]
패키징 기술 의존도가 커지는 이유
1. 성능과 효율성: AI 응용 프로그램은 막대한 연산 능력과 빠른 데이터 처리 속도를 요구하는데 첨단 패키징 기술은 다양한 반도체 칩들을 더욱 효율적으로 결합해 성능을 최적화할 수 있게 해준다.
2. 높은 집적도: 첨단 패키징 공정을 통해 칩 간의 거리가 줄어들어 데이터 전송 시간이 단축되고, 에너지 소비도 줄어들어 AI 작업의 효율성을 크게 향상시킨다.
3. 다양한 기능의 통합: 첨단 패키징 기술은 다양한 기능을 가진 반도체 칩들을 하나의 패키지에 통합시킬 수 있어 소형화 할 수 있게 된다.
4. 공간 활용의 효율성: 첨단 패키징은 개별 칩 크기의 소형화와 더 많은 기능을 제공해 기기 크기 축소 및 전력 절감에 기여한다.
5. 비용절감: 첨단 패키징 기술 구현을 위해 초기 장비 투자 비용은 커지나 장기적으로는 생산 효율성을 향상시켜 제품 단가를 낮춰줌.
6. 시장 수요: IoT, 자율주행, 스마트폰, 서버 등 다양한 분야에서 AI활용이 증가해 수요도 급증하고 있다.
용어정리
한국IR협의회 보고서에서 반도체 투자할 때 알아두면 좋은 여러 단어들을 정리해 두었더라구요. 그래서 참고자료 파트에 요약해서 정래해보았습니다. 만약, 잘 이해가시지 않거나 원본으로 보고 싶은 분들이 계시다면 한국IR협의회 보고서를 참고하시면 됩니다.
1. IDM
*종합반도체 업체를 의미함.
*반도체 설계, 전공정, 후공정까지 전반적으로 사업을 영위하는 기업.
2. OSAT
*반도체 공정 중 후공정에 해당하는 패키징과 테스트 사업을 영위하는 기업.
3. 핸들링 장치
*반도체 업계에서는 일반적으로 핸들러라고 불리는 Pick and Placement 장치.
4. 범프
*반도체 칩을 패키지 기판에 플립칩 방식으로 연결하거나 FC-BGA와 FC-CSP 등을 회로 기판에 직접 전기적으로 연결하기 위한 전도성 돌기.
5. CSP
*패키지 이후 크기가 패키지 전 상태의 반도체 칩 크기와 거의 비슷한 패키징.
6. HBM(High Bandwidth Memory)
*메모리 반도체 중 고대역푝 그래픽 DRAM.
*고대역폭 DRAM을 여러 개 모아서 TSV(Through Silicon Via) 방식으로 수직 연결해 데이터 처리 속도를 혁신적으로 끌어올린 고부가가치, 고성능 제품.
*SK하이닉스, 삼성전자, Micron 중에서 SK하이닉스 점유율이 상대적으로 높음.
7. TSV(Through Silicon Via)
*DRAM 칩에 수천 개의 미세한 구멍을 뚫어 상하층 칩의 구멍을 수직 관통하는 전극으로 연결하는 기술.
*기존 와이어 본딩이 건물의 각 층을 연결하는 계단이나 에스컬레이터라면, TSV는 각 층을 수직으로 관통한다는 의미에서 계단이 애초에 존재하지 않는 건물의 엘리베이터와 비슷함.
8. 에폭시 밀봉재(EMC, Epoxy Molding Compound)
*패키징용 소재.
*열경화성 에폭시 고분자 재료와 무기 실리카 재료를 혼합한 복잡 재료를 기반으로 만들어진 방열 소재.
*반도체 칩을 밀봉해 열이나 습기, 충격 등 외부 환경으로부터 보호해주는 역할.
*EMC와 같은 패키징용 소재로 반도체를 감싸서 보호하는 것도 패키징을 하는 여러 이유 중 하나.
9. MR-MUF(Mass Reflow-molded Under Fill)
*EMC가 반도체를 보호하는 소재라면 MR-MUF는 반도체를 보호하는 공정의 방식을 의미함.
*반도체 칩을 쌓아 올린 뒤 칩과 칩 사이 회로를 보호하기 위해 액체 형태의 보호재를 공간 사이에 주입하고, 최하부의 공간까지 모두 채워서 굳히는 방식.
*MR-MUF 방식은 칩을 하나씩 쌓을 때마다 필름형 소재를 깔아주는 방식 대비 공정이 효율적이고 열 방출에도 효과적인 방식으로 평가받고 있음.
10. TC NCF(Thermal Compression Non Conductive Film)
*칩 사이에 NCF(에폭시와 아크릴 소재가 섞인)라는 절연 필름을 덧대고, 열과 압력을 가해 위쪽을 꾹 눌러서 붙이면 마침내 절연 필름이 녹아 접착되는 공정.
*MR-MUF 도입 전 적용되던 방식으로 SK하이닉스는 MR-MUF 방식을 이용하고 TC NCF 방식은 삼성전자에서 적용한 방식.
11. 범프(Bump)
*반도체 칩과 기판을 연결하는 구 형태의 전도성 돌기.
*범프 형성 소재에 따라 골드 범프 또는 솔더 범프로 구분됨.
12. RDL(Re-Distrivution Layer, 재배선층)
*크기가 작은 반도체 회로와 크기가 큰 기판 회로를 전기적으로 연결하기 위해 중간에 새 회로를 구성하는 것을 의미함.
*RDL 형성을 위해 스퍼터링 공정으로 금속 박막층을 만들고 그 위에 두꺼운 포토레지스트를 도포함. 그 후 포토 공정으로 패턴을 만들고, 패턴 부분에 전해 도금으로 금속 물질을 채워 금속 배선을 형성함.
13. 칩렛(Chiplet)
*칩을 기능별(컨트롤러, 고속 메모리 등)로 쪼개어 별도의 웨이퍼로 제작한 후, 각각의 칩 조각을 하나의 기판 위에 수평 또는 수직 적층한 뒤 서로 연결하는 기술.
*2.5D 패키징, 3.0D 패키징은 칩렛 구조의 일종.
-2.5D 패키징: 수직구조와 수평구조가 혼합되어 있음.
-3.0D 패키징: 서로 다른 칩을 수직으로 완벽하게 적층되어 있음.
14. 하이브리드 본딩
*두 가지 유형의 계면(면과 면 사이의)에서 본딩(연결해서 점처럼 이어주는 것)이 동시에 형성되는 것을 나타내기 위해 사용됨.
*하나는 산화물 면끼리의 본딩이고, 다른 하나는 구리로 이루어진 면끼리의 본딩.
*다른 용어로 불리기도 함.
-범프리스(Bumpless) 공정: 서로 연결되는 공간에 범프(돌기)가 존재하지 않을 수도 있어서 불림.
-Copper to Copper bonding 공정: 구리와 구리 면이 서로 접촉한다는 의미.
-갭리스(Gapless) 또는 다이렉트 공정: 기존 패키징과 달리 남는 여유 공간이 거의 없어서 불림.
[개인해석]
약 4배의 상승을 한 후에 주가가 조정을 보이고 있는 기업입니다. 그래서 제가 주로 보는 PBR밴드로는 상단을 찍은 후 중간정도까지 내려온 상황입니다. 일단 인텍플러스의 사업분야는 모두 고성장 산업들이라 할 수 있을 것 같습니다. 반도체 후공정에서도 HBM에 관련 되어있기 때문이고, 2차전지와 스마트 팩토리 등이 있기 때문입니다. 그리고 OLED도 앞으로 좋아질 것으로 보이기 때문에 성장성이 있다고 볼 수 있습니다. 23년도 예상 실적으로는 적자인데 24년부터는 흑자 전환 후에 고성장하는 부분이 있더라구요. 이렇게 보니 최근 상승이 단순히 고평가라고만 보기에는 좀 어렵겠네요. 당분간 주가가 조정을 보이겠지만 만약 좀 길게봐도 괜찮다고 생각이 되신다면 천천히 분할매수하면서 접근해도 괜찮다고 생각이 듭니다.
[저는 기업들을 제 나름대로 공부하면서 그 공부한 것을 정리하는 사람입니다.
저는 한 사람의 투자자일뿐, 투자 전문가가 아닐 뿐더러 기업분석 전문가도 아니라는 것을 말씀드립니다.
모든 투자 판단은 본인이 해야하며, 그 책임 또한 본인에게 있음을 알려드립니다. ]
'기업(종목) 정리' 카테고리의 다른 글
| [기업분석] "AP위성" 알아보기 (0) | 2023.10.04 |
|---|---|
| [기업분석] "테크윙" 알아보기 (1) | 2023.10.03 |
| [기업분석] "에스티아이" 알아보기 (2) | 2023.09.25 |
| [기업분석] "롯데에너지머티리얼즈" 알아보기 (2) | 2023.09.20 |
| [기업분석] "코윈테크" 알아보기 (2) | 2023.09.18 |



