[이 글은 경제·산업·기업 등을 공부하면서 알게 된 여러 내용을 제 나름대로 요약·정리하며 쓴 글입니다.
맨 아래에 자료 출처를 표기해 두었으니 더 자세히 알고자 하시는 분은 아래 자료출처를 참고하여 찾아보시기를 바랍니다.
문제가 있는 부분을 알려주시면 수정 혹은 삭제조치 하겠습니다. ]

[간단요약]
1. DDI, PMIC, CIS 등의 시스템 반도체 후공정 사업을 하는 기업니다.
2. TV, 스마트폰 출하량과 실적 연관성이 있다.
3. 주요 고객사로 삼성전자, LX세미콘 등이 있다.
4. 저평가 구간이다.
[기업정보]
*평판 디스플레이용 Driver IC(DDI) 및 Power Management IC(PMIC), CMOS Image Sensor(CIS) 등 비메모리반도체 Bumping 및 Packaging, Test 등 반도체 후공정 사업을 하는 기업.
-OSAT(Outsourced Semiconductor Assembly and Test)로 불리는 후공정산업은 반도체 칩과 Main Board를 연결하고, 칩을 보호하기 위한 일련의 공정과 반도체 칩의 양불을 판정하는 TEST 등으로 이루어짐.
-디스플레이 구동칩(DDI), 전력관리반도체(PMIC), 이미지센서(CIS) 등 비메모리 반도체의 후공정 사업을 영위함.
*주요 고객사는 삼성전자, LX세미콘
*매출비중은 부문별로 Back-End가 가장 많고, 반도체 아이템별로 DDI가 제일 많음.

[주요사업 및 생산제품]
1. Back-end
*주로 DDI 패키지 담당함.
*COG(Chip on Glass), COP(Chip on Plastic), COF(Chip on Film) 방식을 공급.

(1)COG(Chip on Glass)
*디스플레이 패널의 유리 기판에 직접 붙인 방식.
*Wafer 상태에서 IC 패드 위에 도전성 Bump를 형성시킨 Driver IC를 유리 패널 위에 직접 접속시키는 Bonding 기술.
*고해상도 LCD, OLED 제품에 적용.
*모바일 등 소형 패널에 주로 사용.
(2)COP(Chip on Plastic)
*디스플레이 패널 자체를 PI(poly imide)를 사용하면서 PI의 연장된 부분에 DDI를 붙이는 방식.
*Flexible OLED에 주로 적용.
(3)COF(Chip on Film).
*디스플레이 패널을 필름에 덧대어 붙이는 방식.
*자회사인 엘비루셈에서 담당함.
*중대형 패널에 주로 적용.
2. Bump/RDL
*Bumping: 칩에 범프를 만들어 기판과 전기적, 기계적으로 연결하는 후공정.
*기존에 사용하던 와이어가 아닌 플립칩 형태로 돌기(Bump) 모양의 금속을 형성해 연결함.
-플립칩 기술: 와이어 본딩 대비 IO(Input, Output) 핀의 개수와 위치가 제약이 없고 신호 전달 경로가 매우 짧아 전기적 특성이 우수함.
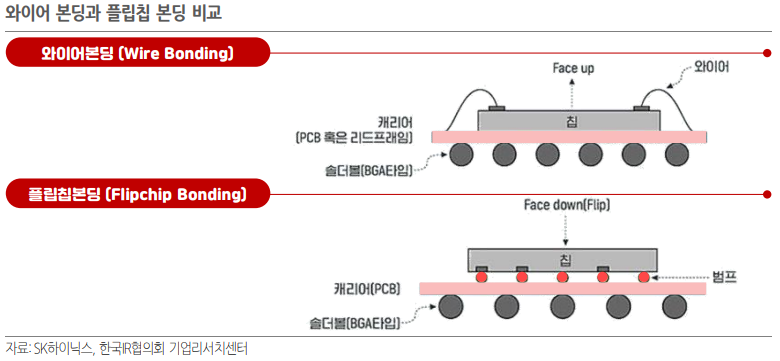
*Au Bump, Solder Bump, Cu Pilar Bump 등을 공급함.
(1)Au Bump
*금으로 Bumping처리해 높은 I/O와 유연한 연결성, 얇고 가벼운 특성을 갖는 웨이퍼 공정 기술.
*소비재에 적용되는 COG(Chip on Glass), COF(Chip on Film), COP(Chip on Plastic) 패키지에 사용.
*wire bond 기술을 대체하기 위해 개발되었으며 금으로 범핑된 칩은 열적 압축 방식을 통해 패키지에 장착됨.
*후대용 제품들에 적합한 방식.
(2)Solder Bump
*COC, fcBGA, fcQNF 등 다양한 플립칩 패키지에 활용됨.
(3)Cu Pilar Bump
*반도체 소자 고성능화, 고밀도화가 급격히 진행됨에 따라 칩의 I/O 밀도가 급속히 증가하면서 미세한 피치 요구에 대응하기 위해 개발된 Bumping 기술.
*피치가 40㎛로 Solder Bump가 150㎛인 것에 비해 미세하여 고밀도 패키지 구현이 가능함.
3. Test
*웨이퍼 테스트 서비스.
(1)EDS(Electrical Die Sorting) 공정
*개별 칩들의 품질 특성이 목표 수준에 도달했는지 확인함.
*프로브 카드에 웨이퍼를 접촉시켜 진행함.
*웨이퍼 테스트 후 패키징 공정이 시작되기에 전공정 가장 마지막 부분에 해당.
*목적: Wafer 상태 반도체 칩의 양품/불량품 선별, 설계 단계에서의 문제점 수정, 불량 칩을 미리 선별해 후속 공정들의 작업 효율을 향상.

*EDS공정 순서: ET Test & WBI(Electrical Test & Wafer Burn In) -> Hot/Cold Test -> Repair/Final Test -> Inking.
-ET Test: 반도체 집적회로(IC) 동작에 필요한 개별소자들에 전기적 직류전압, 전류특성의 파라미터를 테스트함.
-WBI: 웨이퍼에 일정 온도의 열을 가한 다음 AC/DC 전압을 가해 제품의 결함, 약한 부분 등 잠재적인 불량 요인 찾음.
-Hot/Cold: 전기적 신호를 통해 웨이퍼 상의 칩 중 불량품 있는지 판정.
-Repair: Hot/Cold 공정에서 수리 가능한 칩으로 판정받은 칩을 수리함.
-Final Test: 수리 후 이 공정에서 수리가 제도로 이루어졌는지 재차 검증해 양/불량을 최종 판단 함.
-Inking: 불량 칩에 특수 잉크를 찍어 불량을 식별하도록 만듦.

*장비기준 CAPA는 DDI 68%, PMIC 12%, CIS 11%, AP 9% 비중.
4. WLCSP
*웨어퍼 상태에서 한 번에 피키지 공정 및 테스트를 진행한 후 칩을 절단하여 완제품을 만들어 내는 기술.
*가장 작은 크기를 구현할 수 있는 패키지 방법.
*전기적 특성과 가격 경쟁력이 좋아서 모바일 시장에서 수요가 더욱 증가하고 있음.
[출처]
1. LB세미콘 사업보고서(2023.03.17)
2. LB세미콘 한국IR협의회 보고서 2023.03.17
3. LB세미콘 홈페이지
LB세미콘 공식 홈페이지 LB Semicon Website
세계 최고의 기술을 가진 LB Semicon입니다.
www.lbsemicon.com
[개인해석]
LB세미콘의 후공정 산업중 DDI의 수요는 TV와 스마트폰 수요와 직결되어 있습니다. 또한 DDI, PMIC, AP 등은 대부분 스마트폰에 적용되기 때문에 삼성전자 파운드리 생산량이 물량 결정되고, 이는 삼성전자의 스마트폰 출하량과 연동이 되는 부분이 있습니다. 즉 삼성전자의 모바일 부문을 잘 보면 실적에 대한 어느정도의 예측이 가능하겠네요.
일단 PER과 PBR 밴드상으로는 저평가 구간에 있습니다. 다만, 컨센서스가 형성되어 있지 않아 앞으로 실적이 어떻게 될지는 확실히 알 수 없어요. 그래서 삼성전자의 모바일 사업부문이 어떻게 달라지는지 봐야 알 수 있을 것 같습니다.
그래도 최근 반도체 실적이 좋아지는 방향으로 돌아서는 상황이고 한국IR협의회 보고서에는 23년도부터 실적이 괜찮더라구요. 관심을 가지면서 지켜봐도 괜찮다고 생각합니다.
[저는 기업들을 제 나름대로 공부하면서 그 공부한 것을 정리하는 사람입니다.
저는 한 사람의 투자자일뿐, 투자 전문가가 아닐 뿐더러 기업분석 전문가도 아니라는 것을 말씀드립니다.
모든 투자 판단은 본인이 해야하며, 그 책임 또한 본인에게 있음을 알려드립니다. ]
'기업(종목) 정리' 카테고리의 다른 글
| [기업분석] "에프엔에스테크" 알아보기 (0) | 2023.08.31 |
|---|---|
| [기업분석] "엘앤에프" 알아보기 (2) | 2023.08.28 |
| [기업분석] "에코프로에이치엔" 알아보기 (2) | 2023.08.21 |
| [기업분석] "대우건설" 알아보기 (2) | 2023.08.16 |
| [기업분석] "에코프로비엠" 알아보기 (2) | 2023.08.14 |



